
PRODUCT CENTER
产品中心
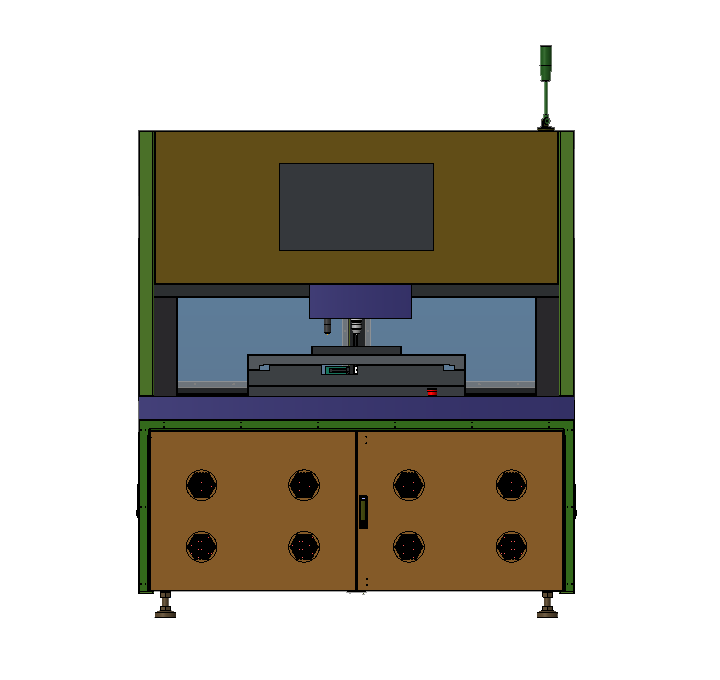
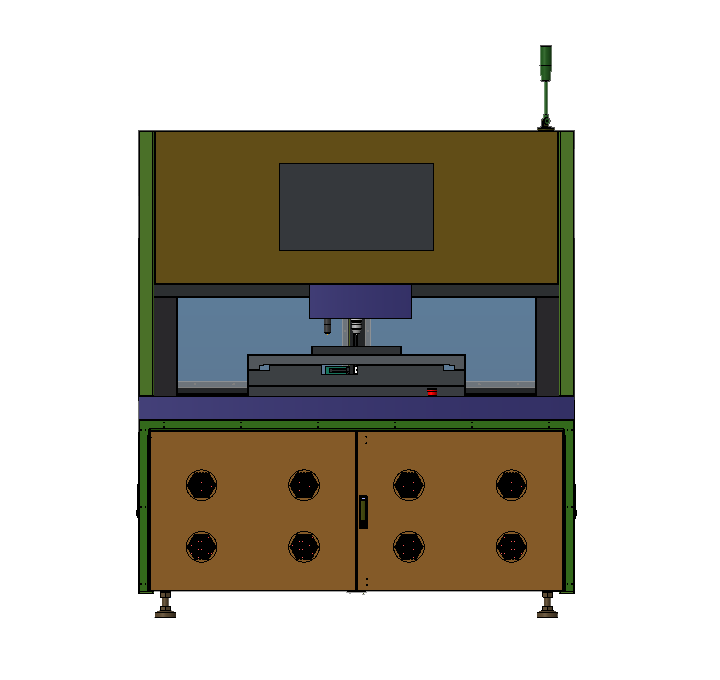


3D轮廓测量设备ES-450
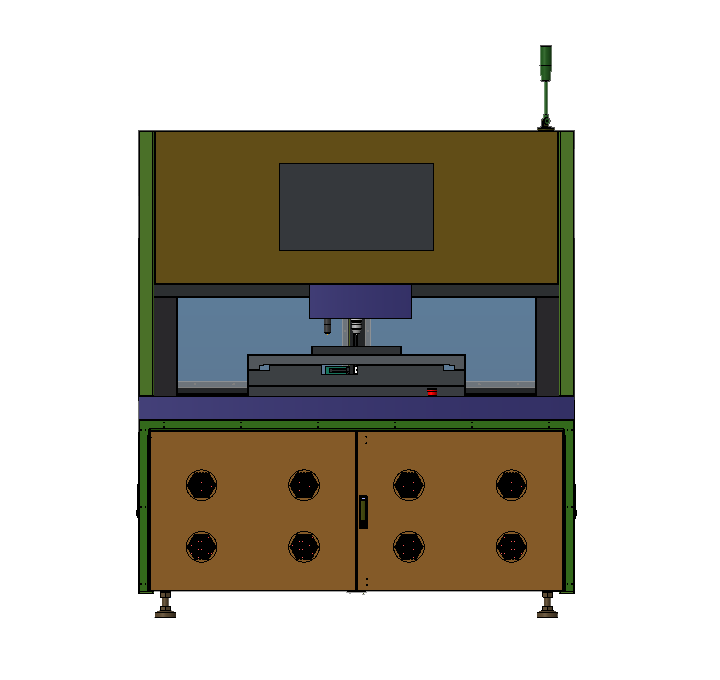
产品描述:
本设备为大行程纳米级3D膜厚分析系统,基于白光干涉+共聚焦融合技术,实现450mm×450mm超大范围的高精度测量。专为半导体封装、先进封装(TSV/Bump)、MEMS微结构及晶圆级光刻胶厚度检测设计,支持0.2μm重复精度与10nm级垂直分辨率,满足工业级高稳定性检测需求。
类别 | 技术参数 |
光学系统 | 光源:白光LED+单色激光双光源系统 物镜:5X-100X电动切换(NA 0.15-0.9) 探测器:12bit高速CMOS (帧率500fps) |
运动性能 | X/Y轴速度:1-10mm/s(速度-精度自适应调节) 运动性能 Z轴扫描速度:50μm/s(高精度模式)/200μm/s(快速模式) |
测量能力 | 膜厚量程:1nm~10mm(透明/金属多层) 测量能力 粗糙度:Sa0.5nm~50μm(符合ISO 25178) 台阶高度:±0.1μm@100um(重复性) |
数据分析 | 3D点云密度:2000万点/区域(0.5μm间距) 数据分析 内置分析:CD-SEM对标算法、厚度分布CPK分析 输出格式:GDSII,OASIS,CSV, 3D PDF |
环境适应性 | 温度:15~30℃(恒温选配±0.5℃) 环境适应性 湿度:<70% RH(防冷凝涂层) 洁净度:Class 1000(FFU过滤模块选配) |
硬件配置 | 定位系统:真空吸附+机械夹具双模式(吸附力0~-90kPa) 安全防护:激光安全等级Class 1,急停按钮+光栅防护 |
应用场景:
类别
技术参数
先进封装
Bump高度一致性(±0.5μm)
先进封装 TSV深宽比测量(深孔>100μm,直径<5μm)
铜柱侧壁垂直度(角度误差<0.1°)
晶圆制造
光刻胶厚度均匀性(CD均匀性≤1%)
晶圆制造 刻蚀图形侧壁粗糙度(Ra<10nm)
CMP后铜层残余厚度(0.1μm分辨率)
MEMS器件
悬臂梁厚度(1~100μm)
MEMS器件 微流道深度(>50:1深宽比)
惯性传感器台阶高度(重复性±0.05um)
显示面板
ITO膜厚(70~150nm,±1nm)
显示面板 OLED封装层3D形貌(台阶高度>5μm)
玻璃基板翘曲度(450mm全域平面度<2μm)
工作时间:周一至周六 8:30 — 18:30

Copyright@ 2017-2020 易泛特技术(深圳)有限公司 www.effecttek.com 版权所有 粤ICP备20001893号 技术支持:美橙互联
—
扫一扫
关注
—

易泛特技术(深圳)有限公司
公司地址:深圳市宝安区新桥街道上寮工业路18号汇聚新桥107创智园B207
联系人:柏先生
邮箱:jeff@effecttek.com
手机:18929339897






